导电探针原子力显微镜使用锋利的导电探头以纳米级分辨率绘制样品电导率的局部变化。此处描述的导电探针原子力显微或C-AFM方法是SPM系列中的一种电学模式。它用于研究样品的电导率和成像电学特性,比如纳米级的电荷传输和电荷分布。 C-AFM被应用于纳米电子领域,太阳能电池和半导体行业,用于各种高分辨率测量,包括半导体掺杂剂分布图以及介电膜和氧化物层的质量控制。
在导电探针原子力显微镜中,尖锐的导电尖端与样品接触。在这种接触过程中,在探针和样品之间施加偏压,并在探针光栅扫描整个表面时测量两者之间的电流,形成电导率或电流图。此模式类似于扫描隧道显微镜(STM),它是原始的SPM技术。 C-AFM提供了优于STM的关键优势,因为C-AFM使用导电悬臂而不是锋利的金属线。另外,C-AFM通过所有在AFM测量中使用的光束偏转检测器系统对形貌成像。用低噪声,高增益前置放大器测量电导率。通过这种设置,可以在C-AFM中独立地收集地形和电流信息(不同于STM,其形貌和电流图像相互依赖),这可以最小化两个信号相互的干扰和伪像,并简化了对获取的电导率图和电流图的解释。
C-AFM中的导电探头具有薄的导电涂层。常见的导电涂层是铂,金,钨和导电金刚石。这些悬臂不昂贵且可商购。
C-AFM以接触模式运行。在这种模式下,尖端与样品保持不断地接触。尖端设置在样品上的载荷由用户设定,并通过悬臂的偏转进行监控。然后,探头沿表面光栅扫描,使用反馈环路通过z压电运动使此悬臂偏转保持恒定。这种操作模式可能会导致针头与样品的互动非常激烈,从而导致针头快速磨损。结合流过尖端/样品触点的高电流密度,C-AFM探针的磨损速度比用于常规SPM形貌测量的硅基探针要快。
在空气中用导电探针原子力显微镜测量电流是很有挑战性的。探针与样品的接触面积很小(直径在10 nm范围内),从而迅速导致高电流密度(每单位表面积的电流),使悬臂涂层的导电性能迅速恶化。与样品串联的电阻器降低了高导电样品的这种风险。
通常环境条件下存在的尖端和样品之间的表面污染和水膜也会降低C-AFM的可靠性和可重复性。 尖端上只几纳米的碎屑会阻塞电流。 因此,有时需要更大的力,这需要更硬的尖端材料或涂层,例如导电金刚石类涂层或硅化铂,因为这些高的力负载会使尖端很快被磨坏。
最后,还可以使用C-AFM收集电流-电压(I-V)曲线的局部单点测量。 对于这些电学测量,用户将探头放在样品表面上的所需位置,并在收集电流的同时使偏置电压逐渐变大。
C-AFM示例
下面是HOPG表面的500nm x 500nm C-AFM图,其中z轴范围仅为80 pA。 在低电流图像的对比度下,可以很容易地观察到HOPG中不同层的不同电导率(深红色和亮红色)。

C-AFM应用的另一个例子来自催化剂材料行业。 具有阴极催化剂层的燃料电池由嵌入碳基质中的铂纳米颗粒组成。 电子传输被相邻铂颗粒之间的电子隧穿所支配,因此铂颗粒密度决定了阴极层的导电或绝缘性质。
在该示例中, C-AFM 监控了碳基质层在被电子束辐照时的电导率变化。 辐照氧化了碳,使基体更加致密,并缩短了铂纳米颗粒之间的距离。AFM形貌图像显示了电子束辐照的不同点,其中形貌凹陷显示了薄膜在这些点变致密了。 测形貌的同时,使用C-AFM测量这每一点的电导率如下所示。 图像右侧具有较高辐照剂量的薄膜较致密处(即更多的地形凹陷)对应于这些区域中的局部电导率增加。
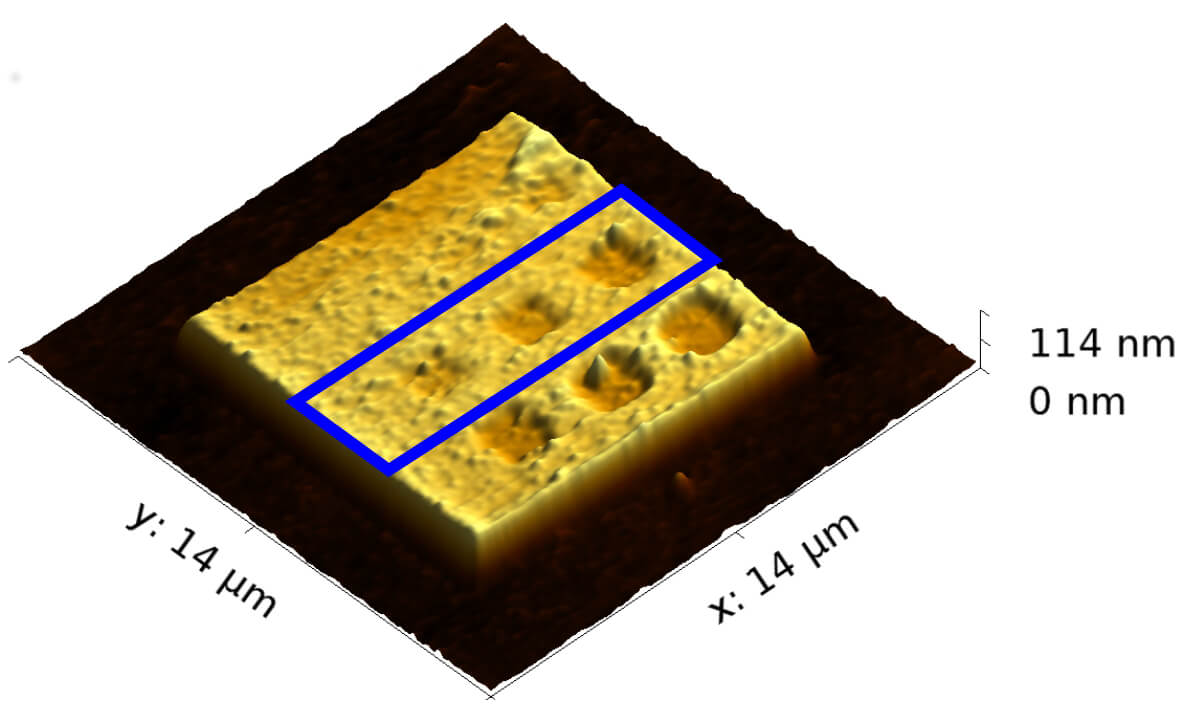
不同电子束剂量辐照下Pt(C) 薄膜的3D 形貌

通过形貌图中蓝色矩形区域内薄膜的电流
应用示例: 在具有多个晶体管触点的抛光IC表面上进行导电探针原子力显微镜 (C-AFM)测量
C-AFM 存在于 所有 Nanosurf AFM 产品线中.

